大日本印刷株式会社(本社:東京 代表取締役社長:北島義斉 資本金:1,144億円 以下:DNP)は、半導体チップを固定して外部と接続をするリードフレームに関して、高精度に銀めっきエリアを形成するとともに、封止材と密着する銅の表面に業界最高水準の粗化(そか)技術(特許出願済み)で密着性を向上させ、信頼性の高い製品を製造する技術を開発しました。DNPは、この「高精度・高信頼性リードフレーム」の提供により、車載用などの半導体パッケージQFN(Quad Flat Non-leaded package)の幅広い用途への展開を目指します。
【高精度・高信頼性リードフレーム提供の背景】
QFNタイプのパッケージは、外部接続のリードがパッケージの外側でなく内側にあるため面積が小さく、半導体チップを固定するダイパッドを樹脂で封入するタイプの半導体パッケージに比べて放熱性が高いことが評価されています。このQFNタイプのパッケージに使われるリードフレームには、チップ性能の向上に関わる“小型・多ピン化”に対応する高精度な銀めっきエリアの形成が必要であり、また車載用のパッケージでは水分の侵入を抑える高い信頼性が求められています。
これらの課題の解決に向けてDNPは、長年培ってきた微細加工技術を生かし、リードフレームの銀めっきエリアの形成を±25um(マイクロメートル=10−6メートル)の高精度で実現するとともに、樹脂とリードフレームの密着性を向上させることで高い信頼性を確保しました。

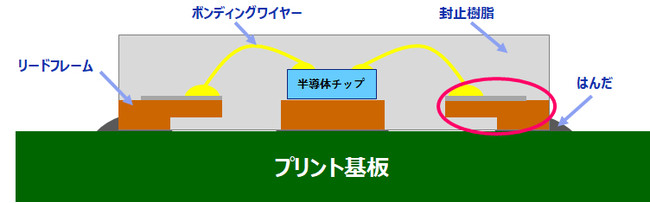
図1:QFNタイプのパッケージのイメージ(赤丸部拡大は図2を参照)
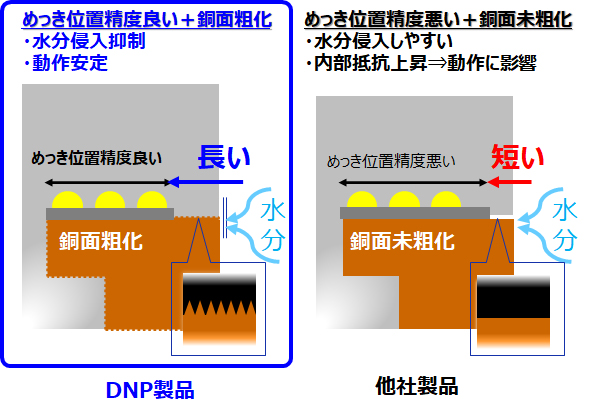
図2(図1の赤丸部分の拡大図):左は今回開発したDNP製品の構造、右は従来の他社製品
【DNPのQFN用リードフレームの特長】
今回開発したDNPのリードフレームは、パッケージ内の樹脂との密着性を向上させるため、密着する銅の表面に業界最高水準の粗化技術を施しています。また、高精度な銀めっきエリアを実現してリードフレームの先端と銀めっきとの適正な距離を確保し、粗化された銅面と樹脂との接触面積を大きくすることで、パッケージ内への水分の侵入を抑える高い信頼性を確保しました。
この製品は、半導体パッケージ封止樹脂の空気中水分の吸湿と、この水分の気化による体積膨張から破損に至る現象の防止を目的に制定されたJEDEC(Joint Electron Device Engineering Council)の規格であるMSL(Moisture Sensitivity Level)のうち、最高レベルのMSL1(温度30℃、湿度85%以下)の環境でも最高度の永続性(寿命なし)があると評価されています。

【今後の展開】
今後DNPは、今回開発した「高精度・高信頼性リードフレーム」を半導体の後加工メーカーへ提供し、事業の拡大を図っていきます。また、需要の増加に対応するために設備を増強して、2023年度には2020年度に比べて約2倍に生産能力を引き上げる計画です。
企業プレスリリース詳細へ
PR TIMESトップへ


